
目前,集成电路产业不断生产集成度、封装密度、功率密度越来越高的微电子元器件,对散热提出了更高的要求。电子封装材料用于将这些微电子组件包装在一起,有助于散热、重新分配压力,并保护整个系统免受环境影响。它们在确保电子设备的性能和可靠性方面发挥着重要作用。在各种封装材料中,环氧基底填充材料常用于倒装芯片封装。然而,广泛使用的毛细管底填充材料导热系数低,无法满足功率密度更高的下一代IC芯片日益增长的散热要求。人们已经提出了许多改善环氧树脂导热系数的策略,但其作为具有复杂性能要求的底填材料的应用仍然很困难。事实上,优化倒装芯片封装底部填充材料的综合热-电-机械加工性能仍然是一个巨大的挑战。
近日,悉尼大学Yiu-Wing Mai,华中科技大学Xiaolin Xie综述了高导热的环氧基复合材料作为电子封装材料的最新进展,这些材料用于具有更高的集成度、封装和功率密度的现代设备的电子封装。
文章要点
1)除了用于散热的导热系数之外,作者还讨论了结构可靠性和性能所需的其他特性,例如热膨胀系数、介电常数和损耗、玻璃化转变温度和电绝缘性,以及毛细管底部填充制造所需的加工粘度。
2)作者指出,设计和制造同时具有所有所需性能的下一代底部填充材料即使不是不可能的,也是困难的。此外,还有成本和扩大生产问题的实际考虑。作者确定了有助于未来实现这些目标的研究方向,包括:i)填料的形状、大小和分布不仅是影响环氧悬浮液流动性的重要因素,也是影响其复合材料导热系数和热膨胀系数的重要因素;ii)核壳球形填料被发现可以增加导热系数,并为其环氧复合材料提供电气绝缘;iii)除了填料的形态外,填料的表面改性在制备导热环氧复合材料作为底填充材料中也起着重要的作用;iv)制造具有高导热系数和其他首选性能的底部填充材料需要特定的填充剂;v)高性能导热底填充材料要求具有阻燃和介电性能;vi)环氧树脂作为底填材料中的连续相,对最终复合材料的使用性能起着至关重要的作用;vii)多尺度分析模型和计算机模拟已被证明是理解底部填充材料的微结构和综合性能之间的基本关系以及它们在芯片和基板之间的毛细流动过程的有力工具。
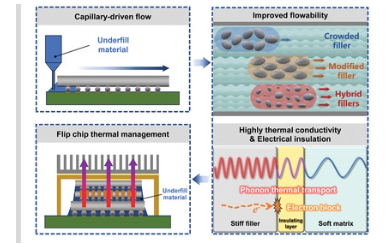
参考文献
Yingfeng Wen, et al, Advances on Thermally Conductive Epoxy-Based Composites as Electronic Packaging Underfill Materials—A Review, Adv. Mater. 2022
DOI: 10.1002/adma.202201023
https://doi.org/10.1002/adma.202201023



















